等离子体增强型CVD设备 PD-2201LC 节省空间的生产系统
|
|
概要PD-2201LC 是一种盒式装载等离子体增强化学气相沉积 (PECVD) 设备,能够沉积硅基薄膜(氧化硅、氮化硅、氧氮化硅和非晶硅)。
主要特点和优点• 最大加工范围:ø220 mm (ø3" x 5, ø4" x 3, ø8" x 1) • 优异的均匀性和应力控制 • 卓越的工艺稳定性和可重复性 • 坚固的系统,最低的运行/维护成本 • 用户友好的触摸屏界面,用于参数控制和配方存储 • PD-2201LC设计时尚、节省空间,只需最小的洁净室空间 • 双频(13.56 MHz + 400 kHz)PECVD,用于卓越的过程控制 应用• SiH4-SiNx • SiH4-SiO2 • 液体前驱体(SN-2)SiNx。 • TEOS-SiO2 |
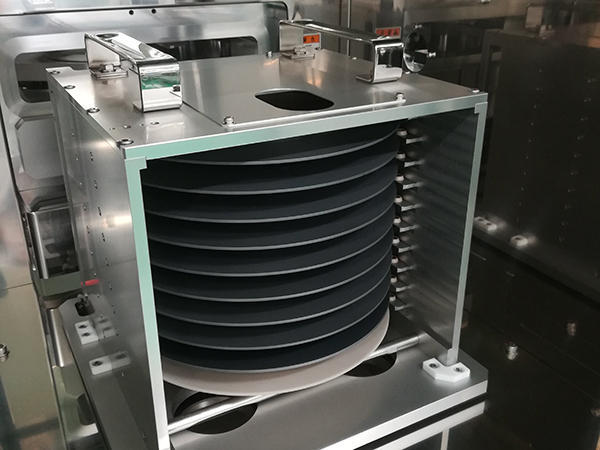 |
|
等离子体增强型CVD设备 PD-220NL 紧凑的研发用负载锁定系统
|
|
概要PD-220NL 是一种负载锁定等离子体增强化学气相沉积 (PECVD) 系统,能够沉积硅基薄膜(氧化硅、氮化硅、氧氮化硅和非晶硅)。
主要特点和优点• 最大加工范围:ø220 mm (ø3" x 5, ø4" x 3, ø8" x 1) • 优异的均匀性和应力控制 • 卓越的工艺稳定性和可重复性 • 坚固的系统,最低的运行/维护成本 • 用户友好的触摸屏界面,用于参数控制和配方存储。 • PD-220NL设计时尚、紧凑,只需最小的洁净室空间。 • 双频(13.56 MHz + 400 kHz)PECVD,用于卓越的过程控制。 应用• SiH4-SiNx |
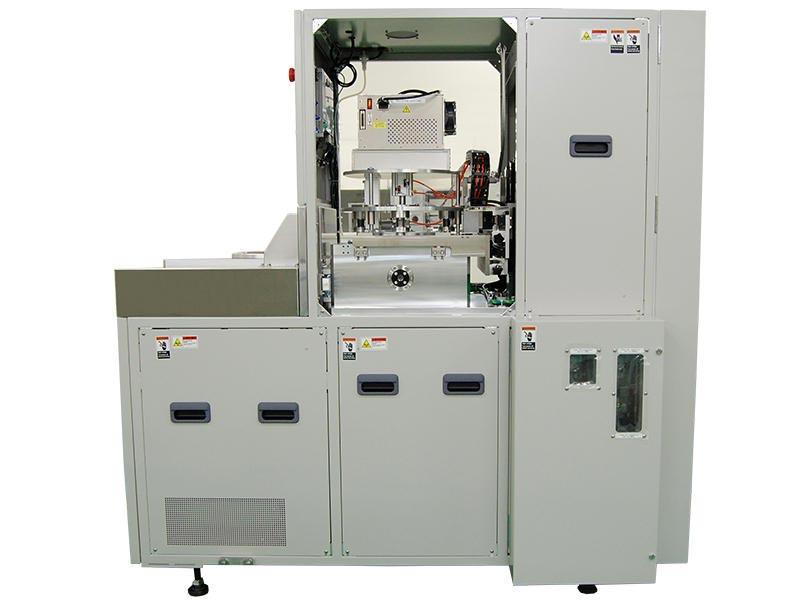 |
|
等离子体增强型CVD设备 PD-220N 研究开发用等离子体CVD设备
|
|
概要PD-220N是用于沉积各种硅薄膜(SiO2、Si3N4等)的等离子体CVD系统。 PD-220N在提供薄膜沉积所需的全部功能的同时,占地面积比本公司的传统系统小40%。 从尖端研究到半大规模生产,它的应用范围很广。
主要特点和优点可在ø8英寸晶圆上沉积 TEOS-SiO2成膜系统可扩展
应用各种硅基薄膜的形成
选项可以增加形成TEOS-SiO2薄膜的TEOS等温室装置。 |








